在微观世界的探索中,扫描电子显微镜(SEM)因其卓越的可视化能力,已成为定性表面形貌分析不可或缺的工具。就形貌学研究而言,SEM所整合的一系列独特属性,是其他任何显微技术都无法比拟的。
它的放大倍数范围极广,可以从低于100×的宏观概览无缝衔接到高达100000×的精细观察。这意味着分析视野既可以覆盖近1 mm²的区域,也能聚焦于仅1 μm²的微区。这种跨越多个数量级的尺度伸缩性,使得SEM成为一种真正的多尺度分析技术,其灵活性远超其他显微方法。
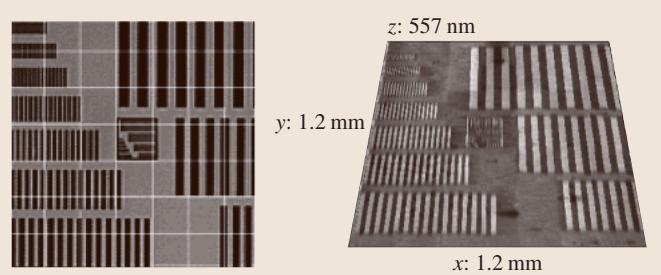 图1 左图:扫描策略;右图:由49个单次扫描拼接而成的AFM图像三维图
图1 左图:扫描策略;右图:由49个单次扫描拼接而成的AFM图像三维图
在高倍率下,SEM在导电样品表面的极限分辨率可达约2 nm,其计量学性能不受光学衍射极限的制约。如此高的分辨能力,只有扫描探针显微镜(SPM)能够企及,但后者在可测范围上又存在局限。SEM的另一大优势是其巨大的景深,能够让处于不同深度的特征同时保持清晰对焦。同时,它还具备很长的工作距离,即使在1000×或更高倍率下,依然可以在数毫米甚至十余毫米的工作距离下轻松成像。这一特性为开发基于多重定位的测量策略提供了可能。此外,市售的SEM通常配备了具有多个自由度的样品台,允许从不同视角对特征进行观察。
尽管通过二次电子探测器获得的SEM图像因其阴影效应而具有引人注目的三维立体感,但其本质上仍是二维的。高度信息无法从单张图像中直接提取,而图像在x和y维度上的测量也仅在单一焦平面上是准确的。
为了重构表面特征的第三维度,可以采用摄影测量学(Photogrammetry)方法。其核心思路是对同一样品从两个不同的视角进行成像,形成所谓的“立体像对”。样品表面的高低起伏,会导致其在两张图像中的横向位移有所不同。通过计算这些投影差异,便可以推导出定量的表面形貌数据。该计算能否成功的根本前提,是在两张图像中对单个表面特征进行精确的匹配。在大多数SEM设备中,通过绕水平轴倾斜样品台,即可方便地获取这两个不同视角的立体图像。
利用立体像对或像组重构出的三维数据虽然可用于评估表面形貌,但其应用受到多种因素的制约。
首先,SEM测量要求样品材料本身具有导电性,或是在表面沉积一层金等导电薄膜进行制备。一个主要的限制在于,粗糙度等参数的计算通常需要在一个相对较大的面积上进行,而当使用高倍率时,SEM的视场面积又相对很小,这构成了一对矛盾。另一个限制是,对于非常光滑的表面,三维重构结果会存在较高的不确定性。因此,要获得可靠的定量三维数据,对样品制备、参数优化和数据处理都提出了极高要求。
精工博研测试技术(河南)有限公司(原郑州三磨所国家磨料磨具质量检验检测中心),央企,国字头检测机构,专业的权威第三方检测机构,专业检测表面形貌与微观结构分析,可靠准确。欢迎沟通交流,电话19939716636
为了推动该技术的发展,丹麦技术大学(DTU)的研究人员针对立体像对SEM的表面织构测量可溯源性展开了深入研究。他们开发了一种实现伪同心倾转(pseudo-eucentric tilting)的定位程序,并基于现有理论,结合同心倾转假说,给出了一个计算形貌测量精度的模型。此外,为了有效测试高倍率下三维SEM的性能,一项新颖的校准样件设计也被提了出来。这些工作为提升SEM三维测量的准确性和可靠性铺平了道路。


 首页
首页
 检测领域
检测领域
 服务项目
服务项目
 咨询报价
咨询报价